

HIGH-RESOLUTION DIFFRACTION
Высокая мощность, точность и гибкость многофункционального порошкового дифрактометра
AXRD ® HR
Совершенная лабораторная платформа для расширенных приложений дифракции
AXRD HR оснащен инновационным гониометром, обеспечивающим максимальную точность и точность. Используя последние достижения в области технологий двигателей и кодировщиков, эта система обладает возможностями, необходимыми для проведения экспериментов с высоким разрешением на ваших эпитаксиальных тонких пленках, многослойных покрытиях и монокристаллах.
С помощью этой передовой системы вы можете определять коэффициент отражения рентгеновских лучей (XRR) для определения физических свойств поверхности ваших тонких пленок, многослойных покрытий и границ раздела фаз. Кривые качания с высоким разрешением могут использоваться для анализа эпитаксиальных монокристаллических пленок и определения кристаллического совершенства объемных монокристаллов. Наконец, карты обратного пространства предоставляют ценную информацию об эпитаксиальных тонких пленках и позволяют анализировать напряженные пленки.

ОТРАЖЕНИЕ РЕНТГЕНОВСКОГО ИЗЛУЧЕНИЯ (XRR)
Опишите физические свойства поверхности ваших тонких пленок, многослойных покрытий и поверхностей раздела.
Определите следующую информацию:
- Толщина слоя
- Шероховатость поверхности и интерфейса
- Плотность
- Химический состав
- Плотность дислокации
Можно анализировать аморфные, поликристаллические и монокристаллические слои.

КАЧЕСТВЕННЫЕ КРИВЫЕ
Кривые качания с высоким разрешением могут быть использованы для анализа эпитаксиальных монокристаллических пленок и определения кристаллического совершенства объемных монокристаллов.
Определите следующую информацию:
- Состав и толщина слоя
- Несовпадение, релаксация (деформация решетки)
- Наклон слоя, кривизна и разориентация
- Мозаичность
- Плотность дислокации
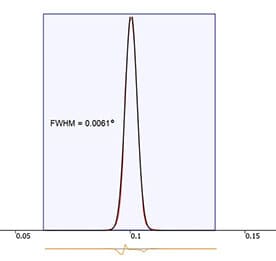
ВЗАИМНОЕ КАРТИРОВАНИЕ ПРОСТРАНСТВА
Этот метод высокого разрешения дает наибольшую информацию об эпитаксиальных тонких пленках и необходим для анализа напряженных пленок.
Определите следующую информацию:
- Отдельные эффекты смещения пика Брэгга для точного определения деформации, состава, параметров решетки и толщины слоя
- Различайте напряжение и композиционные изменения
- Различайте уширение из-за мозаичного распространения или кривизны

